开大阪大学科学家们展示出一种新的技术 建立三维集成电路连接 低温运行 不需要外部压力这可能产生节能电子设备
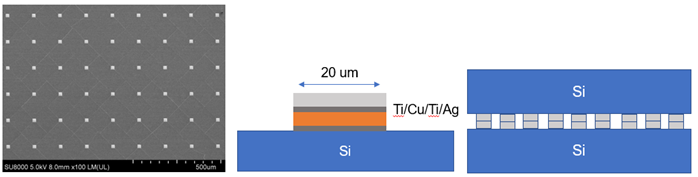 SEM图象编译20-mCu-Ag波段图解图像感想大阪大学
SEM图象编译20-mCu-Ag波段图解图像感想大阪大学
大阪大学弹性三维系统集成实验室研究者想出新技术使用银直接三维联结铜电极这会降低新电子设备的成本和能量需求这项工作可能有助于设计下一代智能设备,这些设备少用电多紧凑
三维组合电路在电子设备中起着非常重要的作用与传统二维电路相比,这些架构有可能保存空格并减少互连线所需材料
开发可信赖三维连接的潜力需要新技术,而成熟技术则用于公约集成电路
最近大阪大学研究组展示了如何立即用银层帮助连接铜电极bumps
进程可以在温和条件下实现,温度相对较低,不增加压力,但债券能够承受千次热震周期从-55到125.
郑进大阪大学首创
银子喷射到两个铜表面 以室温绑定取热加固银层, 使表面体验微变
解压时退火导致表面粗糙化,保证两银层间适当有效区
因此,在没有压力的情况下实现联结是可能的,即使是在相对较低的退火温度下实现联结也是可能的。最小至20微米的永久连接在10分钟内可用此方式识别这一过程也只需要中度温度(180摄氏度)并可在大气条件下运行
团队利用原子力显微镜镜像和扫描电子显微镜检验法验证喷射和退火芯片表面粗糙度
高密度互连和高级三维打包.
Katsuki Suganuma研究高级作者大阪大学
源码 :https://www.osaka-u.ac.jp/en